顕微鏡観察に先立ち何らかの加工・前処理が必要になる場合がほとんどです。

機械研磨による半導体の観察例
半導体の構造観察や不良解析における断面作製方法には、CPやFIB、機械研磨が挙げられますが
それぞれ一長一短あり、どの方法で作製するのか検討が必要です。近年ではCPやFIBが一般的になってきており技術を要する機械研磨は減りつつあるように感じます。しかし、まだまだ捨てたものではございません。下記に機械研磨による各種半導体の断面観察例をご紹介します。
(各手法のメリット、デメリットについては、販促...
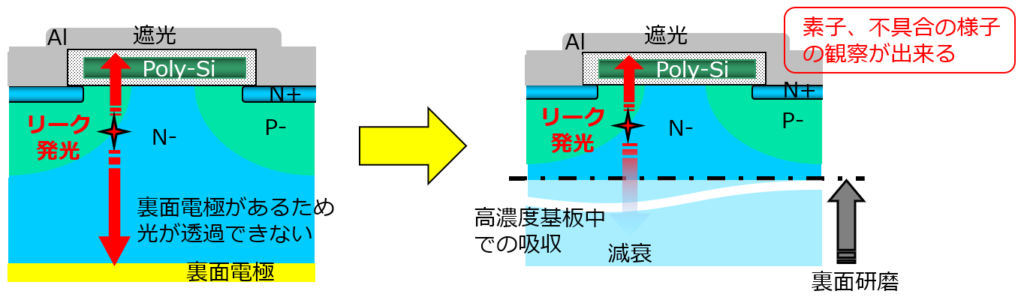
発光解析のための半導体の裏面研磨
裏面OBIRCH/発光解析や裏面発光解析の前処理として各種形態のサンプルの裏面研磨を行います。裏面から解析を行うため不可欠な前処理です。
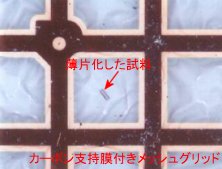
FIB(集束イオンビーム装置)を使用したTEM試料作製
リフトアウト法を用いたTEM試料作製は、短時間で近接する個所での試料作製が可能です。
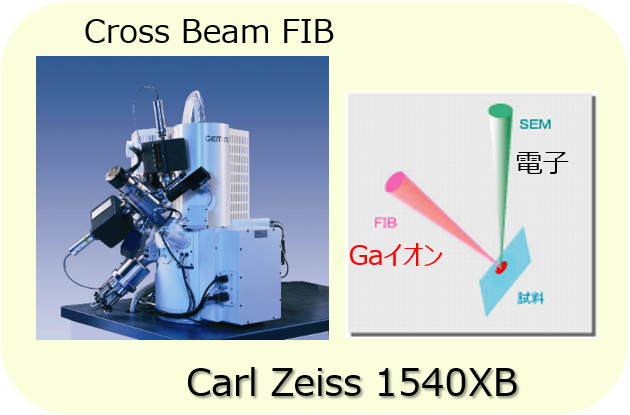
FIB(Focused Ion Beam)
FIB(集束イオンビーム)はGaイオンを数μm以下に絞り、ビームを走査させて試料表面の原子を弾き飛ばしながら微小領域を加工する装置です。半導体、MEMS、液晶ガラス、ビルドアップ基板など、微小領域の断面加工やTEM試料の作製が可能です。






