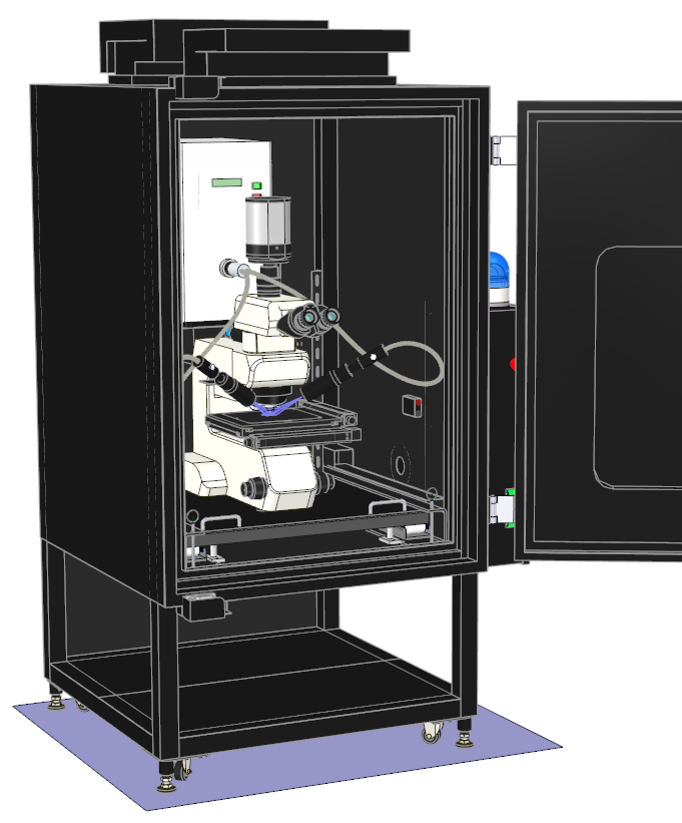
SiCにおけるPL発光箇所のTEM観察
SiC基板中に存在する基底面転位(BPD)は、順バイアス時に欠陥を拡大させ、デバイス特性を劣化させることで知られています。今回、微小なBPDをPL(フォトルミネッセンス)にて特定し、発光部をTEMにて観察しました。
装置概要
PL(フォトルミネッセンス)
使用装置:
自社製PLイメージング装置励起光:超高圧水銀ランプUV光源 (285~350nm)
捉えたい欠陥の種類によ...

信頼性試験によるスペック確認と故障解析
信頼性試験から、故障解析までの一貫した解析をする事で、サンプルが規格を満たしているか確認すると共に、Failしたサンプルの不良箇所の特定及び観察をする事が可能となります。
信頼性試験による半導体素子のスペック確認
試験機:ESD・ラッチアップテスターM7000/東京電子交易製対象サンプル:SiC MOSFET PKG印加規格:HBM(100pF/1.5kΩ)GS間で1u...

Talos F200E導入のお知らせ
最先端の透過型電子顕微鏡システム FEI製Talos F200Eを導入します。従来機と比べTEM・STEMの分解能が向上し、4本の検出器でEDS分析が可能になるなど性能が大幅に強化されます。ドリフト補正フレーム積算(DCFI)による観察とEDS Super-Xシステムによる分析の事例を紹介します。2025年12月 サービス開始しました!
フルデジタル分析電子顕微鏡システム Talos...
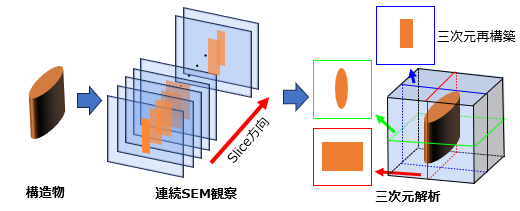
パワーデバイス故障箇所・Slice&View 三次元再構築
電力変換素子として広く活用されているパワーデバイスのEOSによる故障箇所をOBIRCH解析で特定した後、FIB-SEMのSlice&View機能を用いて故障箇所の三次元像を再構築する事により、破壊された構造の全貌を観察してみました。
Slice&Viewと三次元再構築について
新規導入したFIB-SEM装置
Helios5UC(FEI製)のSlice&View機能(自動でFIB加工とSEM観...
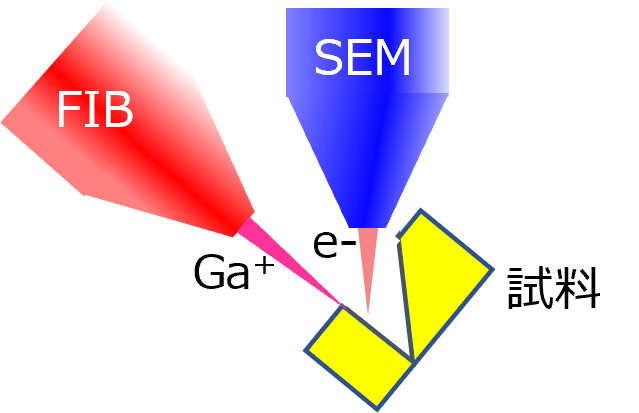
FIB-SEM Helios 5 UC 導入のお知らせ
パワーデバイスやIC、太陽電池や受発光素子といった半導体デバイスやMLCCなどの電子部品からソフトマテリアルといった多岐にわたる硬軟材料の断面観察・分析を高スループットで実現。
FIB-SEM複合装置概要
・垂直方向にSEMカラム、斜め方向にFIBカラムを搭載。・FIB加工中の様子をSEMでリアルタイムに観察が可能。 ・加工...
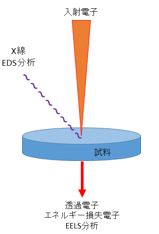
EELS分析手法による膜質評価
EELS分析とEDS分析はTEM試料に加速した電子を照射することで元素同定を行う分析手法です。EELS分析とEDS分析の違い、分析事例をご紹介します。
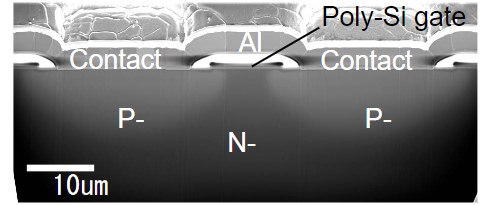
クロスビームFIBによる断面SEM観察
微細FIB断面加工と高精細なSEM観察の受託サービスです。
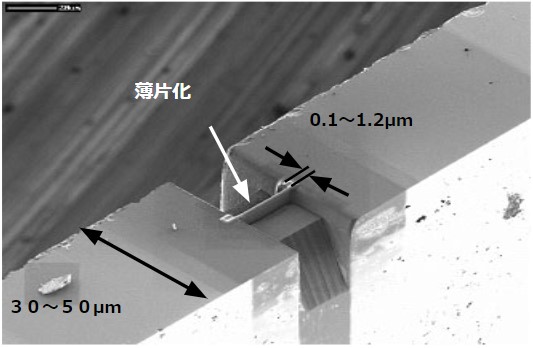
TEMによる電子部品・材料の解析
TEM(透過型電子顕微鏡)観察は、電子部品の故障部位観察、長さ測定、元素分析、結晶構造の解析等や材料評価の幅広い要求にお応えする受託分析です。

TEMによる結晶材料の解析
TEM(透過型電子顕微鏡)は高分解能での結晶粒観察、電子線回折による結晶構造の解析など、結晶材料解析に最適な手法です。
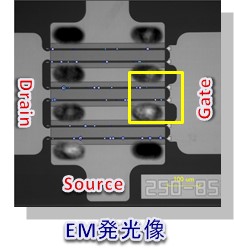
GaN HEMT不良部の結晶欠陥解析
GaN HEMT(化合物半導体)にて、電気的な不良箇所を特定後、断面TEMによる結晶解析を行い、リークの原因となる転位の種類を同定し結晶成長の不良を可視化する受託分析です。






