
発熱解析による電子部品の故障箇所特定
ショートやリークに伴う微弱な発熱を高感度InSbカメラで検出する事で半導体等の電子部品の故障部を非破壊で特定する事ができます。更にX線検査装置を用いる事で非破壊での観察も可能です。
発熱解析原理, 装置概要
発熱解析は、電圧印加によってリーク箇所に発生する熱を高感度InSbカメラで検出する事で不良箇所を特定する手法です。サンプ...
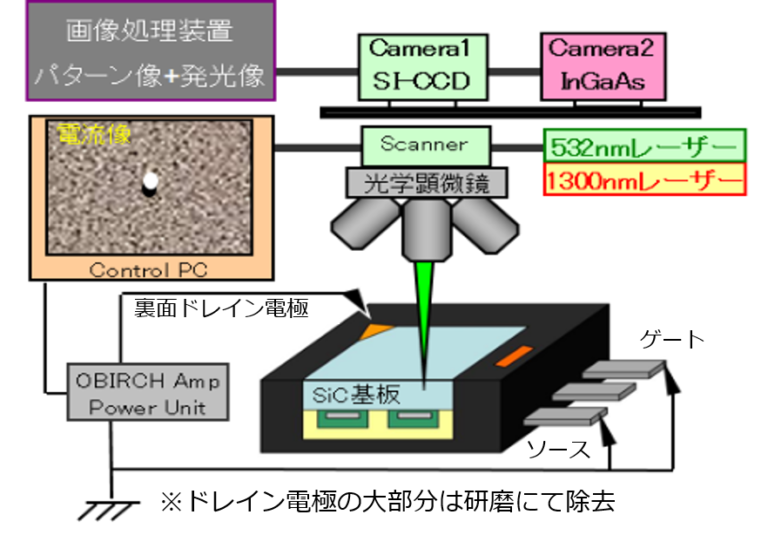
パワー半導体の解析サービス
ICの不良モードに適した様々な手法を組み合わせることで、不良ノードの特定から物理解析まで一貫して対応致します。
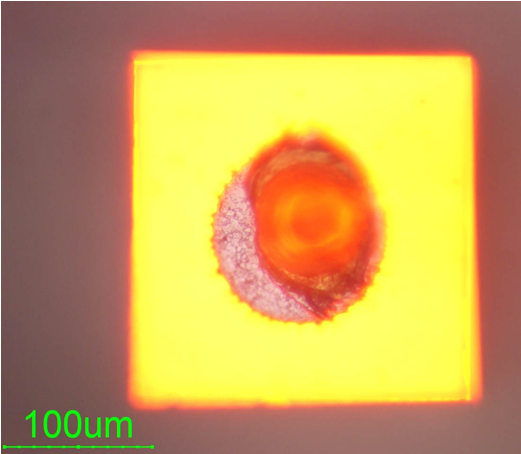
静電破壊した橙色LEDの不良解析
ESD試験にて破壊され、発光強度の低下したLEDはエミッション発光とIR-OBIRCH法を用いて解析し、不良現象を明らかにすることが可能です。

パワーデバイスの故障解析
ダイオード・MOS FET・IGBTといったパワーデバイスの不良箇所を特定し観察する受託分析サービスです。
SiCデバイスの裏面発光解析
SiCは従来のSi半導体と比べ、エネルギーロスの少ないパワーデバイスであり注目を集めていますが、 Si半導体とは物理特性が異なるため、故障解析も新たな手法が必要となります。

短波長レーザーによるOBIRCH解析サービス
SiCは従来のSi半導体と比べ、エネルギーロスの少ないパワーデバイスであり注目を集めていますが、Si半導体とは物理特性が異なるため、故障箇所特定も新たな手法が必要となります。
詳しくはこちら(外部サイト)
お問い合わせはこちら
OBIRCH解析の原理 (Optical Beam Induced R...
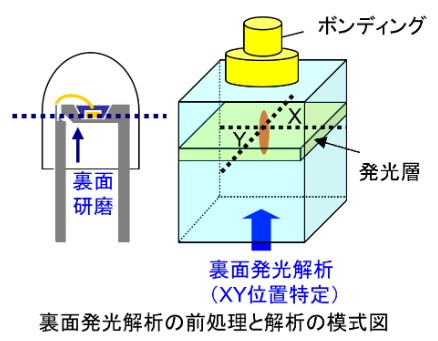
断面発光解析による橙色LEDのリーク不良解析
裏面と断面からのエミッション発光解析を組合わせる受託分析です。LEDのようにアクティブ素子がチップ内部に存在するデバイスでも不良解析が可能です。
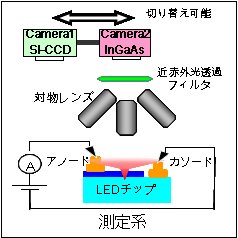
選択波長におけるLED発光解析
Green Deviceとして普及しつつある白色LEDの光源に使用されている青色LEDチップの順バイアス、逆バイアス時のリーク不良箇所を特定する受託分析サービスです。

裏面IR-OBIRCH解析
ICチップの電流リーク、ショートや高抵抗などの不良箇所を、チップの裏面からサブミクロンの位置精度で特定する受託分析です。