TEM
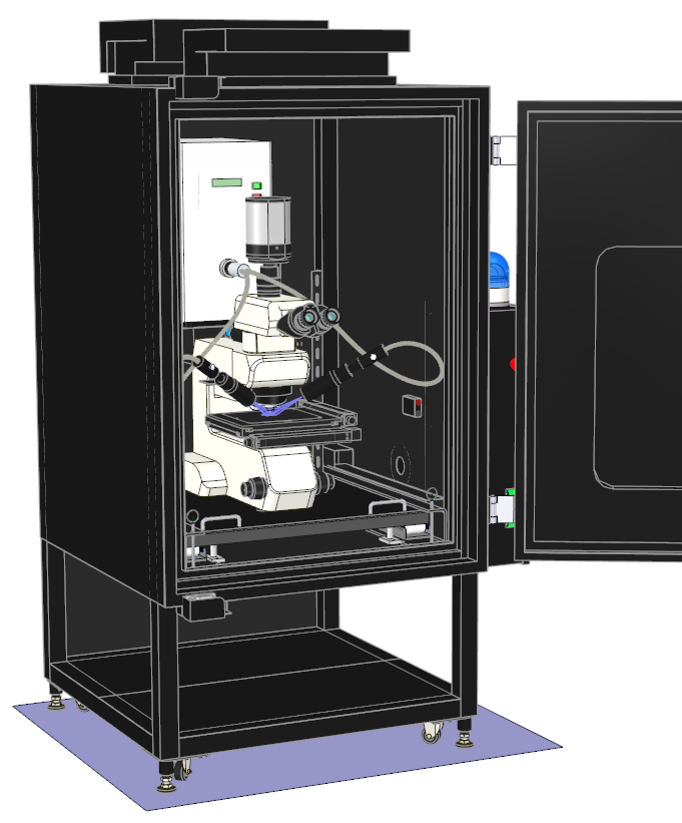
SiCにおけるPL発光箇所のTEM観察
SiC基板中に存在する基底面転位(BPD)は、順バイアス時に欠陥を拡大させ、デバイス特性を劣化させることで知られています。今回、微小なBPDをPL(フォトルミネッセンス)にて特定し、発光部をTEMにて観察しました。 装置...

信頼性試験によるスペック確認と故障解析
信頼性試験から、故障解析までの一貫した解析をする事で、サンプルが規格を満たしているか確認すると共に、Failしたサンプルの不良箇所の特定及び観察をする事が可能となります。 信頼性試験による半導体素子のスペック確認 試験機...

Talos F200E導入のお知らせ
最先端の透過型電子顕微鏡システム FEI製Talos F200Eを導入します。従来機と比べTEM・STEMの分解能が向上し、4本の検出器でEDS分析が可能になるなど性能が大幅に強化されます。 ドリフト補正フレーム積算(D...

不具合の原因を化学の視点で解決します。
クラック、変色、剥離、変形、物性強度低下など、製品、部材などに発生する不具合は様々です。その多くは、製品を構成する材料に原因がある場合が多く、その材料を分析調査することで解決することがあります。何が起きているのかを化学、および反応機構でアプローチする方法をご紹介します。...
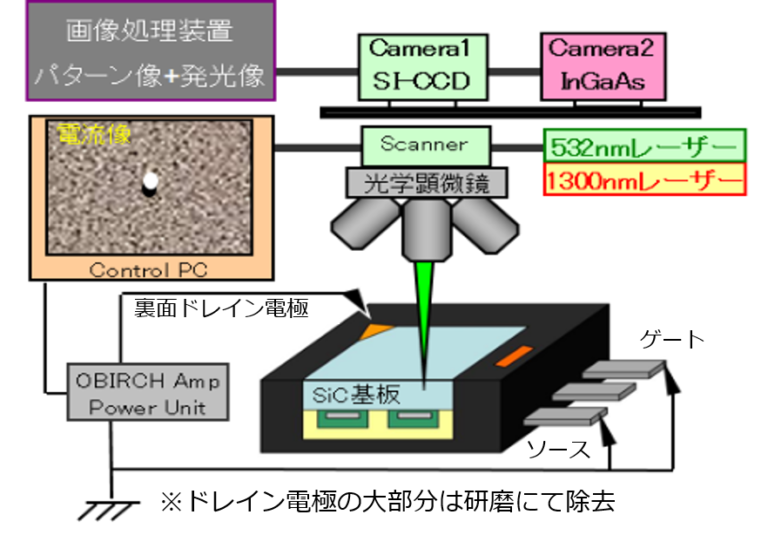
パワー半導体の解析サービス
ICの不良モードに適した様々な手法を組み合わせることで、不良ノードの特定から物理解析まで一貫して対応致します。...

パワーデバイスのトータルソリューションサービス
パワーデバイスをあらゆる角度から徹底評価、検証します...
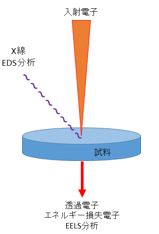
EELS分析手法による膜質評価
EELS分析とEDS分析はTEM試料に加速した電子を照射することで元素同定を行う分析手法です。EELS分析とEDS分析の違い、分析事例をご紹介します。
...

LCDパネルの良品解析
LCD部品/製品の良品解析を行います。弊社の持つLCDの知見から製品の品質状態を確認いたします。...
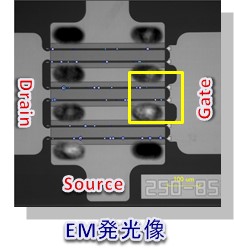
GaN HEMT不良部の結晶欠陥解析
GaN HEMT(化合物半導体)にて、電気的な不良箇所を特定後、断面TEMによる結晶解析を行い、リークの原因となる転位の種類を同定し結晶成長の不良を可視化する受託分析です。...
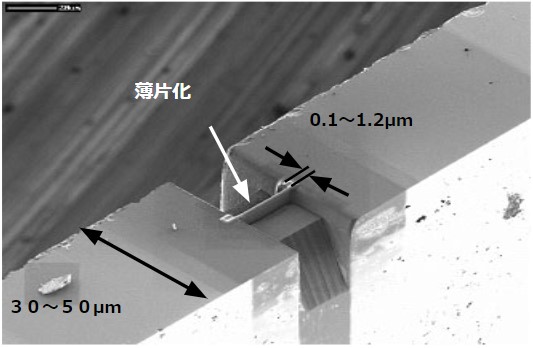
TEMによる電子部品・材料の解析
TEM(透過型電子顕微鏡)観察は、電子部品の故障部位観察、長さ測定、元素分析、結晶構造の解析等や材料評価の幅広い要求にお応えする受託分析です。...
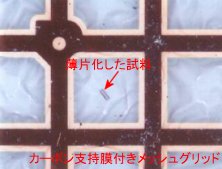
FIB(集束イオンビーム装置)を使用したTEM試料作製
リフトアウト法を用いたTEM試料作製は、短時間で近接する個所での試料作製が可能です。...
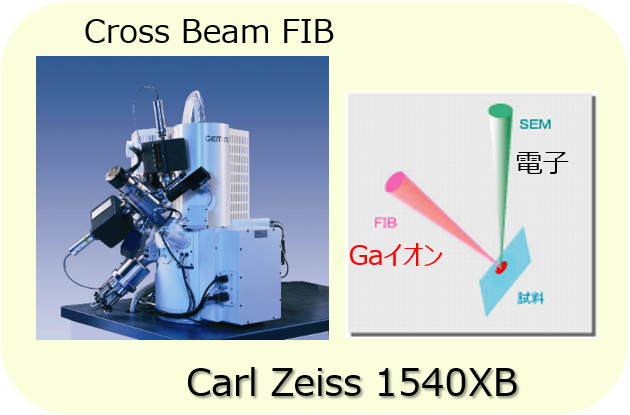
FIB(Focused Ion Beam)
FIB(集束イオンビーム)はGaイオンを数μm以下に絞り、ビームを走査させて試料表面の原子を弾き飛ばしながら微小領域を加工する装置です。半導体、MEMS、液晶ガラス、ビルドアップ基板など、微小領域の断面加工やTEM試料の作製が可能です。...
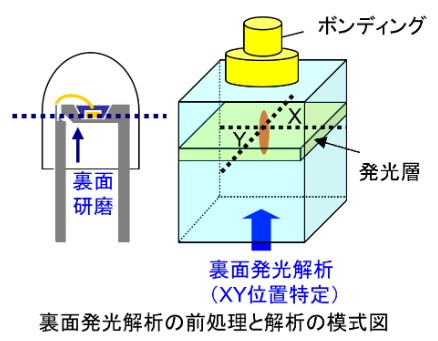
断面発光解析による橙色LEDのリーク不良解析
裏面と断面からのエミッション発光解析を組合わせる受託分析です。LEDのようにアクティブ素子がチップ内部に存在するデバイスでも不良解析が可能です。...

TEMによる結晶材料の解析
TEM(透過型電子顕微鏡)は高分解能での結晶粒観察、電子線回折による結晶構造の解析など、結晶材料解析に最適な手法です。...
装置






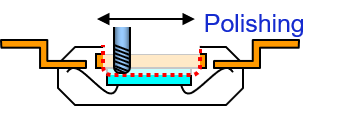

 マイクロプローバー
マイクロプローバー 裏面研磨
裏面研磨 EMS/OBIRCH
EMS/OBIRCH sMIM
sMIM EBIC
EBIC EBAC
EBAC
 光学顕微鏡
光学顕微鏡 デジタルマイクロスコープ
デジタルマイクロスコープ レーザー顕微鏡
レーザー顕微鏡 ワンショット3D形状測定機
ワンショット3D形状測定機 FE-SEM
FE-SEM 卓上型SEM
卓上型SEM FIB-SEM
FIB-SEM TEM
TEM EDX
EDX WDX(EPMA)
WDX(EPMA) EBSD
EBSD トリプルイオンポリッシャー(CP)
トリプルイオンポリッシャー(CP) イオンミリング
イオンミリング 研磨機
研磨機 ウルトラミクロトーム
ウルトラミクロトーム ワイヤーソー
ワイヤーソー 3次元測定器
3次元測定器
 ラマン
ラマン AES
AES XPS
XPS TOF-SIMS
TOF-SIMS AFM
AFM 硬度計
硬度計 FT-IR
FT-IR GC-MS
GC-MS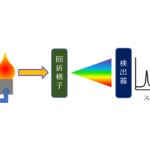 ICP-AES
ICP-AES TMA
TMA DSC
DSC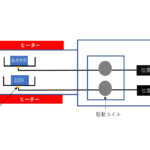 TG-DTA
TG-DTA DMA
DMA イオンクロマト
イオンクロマト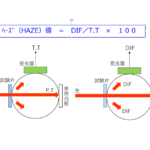 ヘーズメーター
ヘーズメーター NMR
NMR 色差計
色差計 MALDI-TOFMS
MALDI-TOFMS WPA
WPA GPC
GPC 粒子径測定システム
粒子径測定システム 細孔分布測定装置
細孔分布測定装置 万能材料試験機
万能材料試験機
 パワーサイクル
パワーサイクル 熱衝撃(TC)
熱衝撃(TC) 液槽熱衝撃(WTS)
液槽熱衝撃(WTS) ハイパワー恒温恒湿
ハイパワー恒温恒湿 恒温恒湿(THB)
恒温恒湿(THB) 恒温恒湿(TH)
恒温恒湿(TH) 低温(LT)
低温(LT) 高温(HT)
高温(HT) HAST、PCT
HAST、PCT In-Situ
In-Situ ESD・ラッチアップ
ESD・ラッチアップ CDM
CDM 光学測定
光学測定 SAM、SAT
SAM、SAT X線/CT
X線/CT 自記分光光度
自記分光光度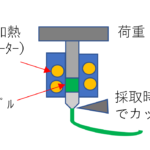 MFR
MFR 全般
全般